
扫码加微信

热门关键词:展至科技 氧化铝陶瓷基板/支架 氮化铝陶瓷基板/支架 陶瓷覆铜板 陶瓷电路板
陶瓷封装外壳
陶瓷封装外壳由于其优越的高气密性、高热传导率、高耐湿性、高机械强度、高绝缘电阻等性能,被广泛应用于混合集成电路、光电器件、声表面波器件、霍尔器件、晶体振荡器和固体继电器等器件封装。

陶瓷外壳能提供芯片气密性的密封保护,使其具有优良的可靠性,具有较高的布线密度,在电、热、机械特性等方面极其稳定。与塑料外壳比较,它的缺点是工艺温度较高,与塑料外壳相比成本较高,具有较高脆性,易致应力损害。陶瓷外壳的主要结构包括底板、盖板、上框、散热板、引线框架、引线、封口环、瓷件、瓷条等。陶瓷外壳按结构可分为片式载体(CC)、饼式外壳(CP)、圆形外壳(CY)、法兰安装外壳(FM)、扁平外壳(FP)、阵列式外壳(GA)、插入式外壳(IP)、螺栓安装外壳(PM)、其他外壳(Ss)。
陶瓷是硬脆性材料,陶瓷封装属于气密性封装,是高可靠度需求的主要封装技术,主要材料包括氧化铝、氧化铍和氮化铝等。
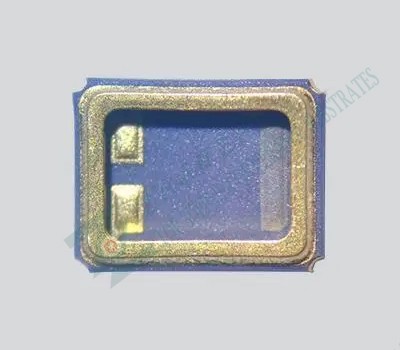
随着电子产品各方面性能要求的不断提高,陶瓷封装外壳在高可靠、大功率电子器件中有了很广泛的应用,芯片需要封装外壳在确保机械保护和密封可靠以外,有很好的与外界的导电、导热能力。这就要求陶瓷要能够与和不同的金属很好的封接,其中金属化工艺是关键的一道工艺过程。金属化是指在陶瓷上烧结或沉积一层金属,以便陶瓷和金属能高质量的封接在一起。金属化的好坏直接影响到封装的气密性和强度。
